歡迎訪問深圳創(chuàng)精銳電子有限公司官方網(wǎng)站!專業(yè)生產(chǎn)激光焊錫機(jī),全自動(dòng)焊錫機(jī),全自動(dòng)激光焊錫機(jī),全自動(dòng)點(diǎn)膠機(jī)等自動(dòng)化設(shè)備!
免費(fèi)咨詢熱線
13143414391
高速點(diǎn)膠機(jī)通用工藝有:底部填充、FPC封裝、手機(jī)邊框點(diǎn)熱熔膠、SMT點(diǎn)紅膠、LED lens點(diǎn)膠、IC邊緣封裝等。

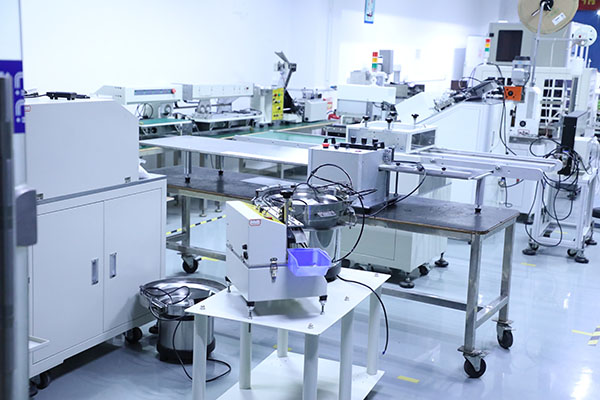

幾乎所有這幾種封裝材料都需要很長的固化時(shí)間,所以用在線式連續(xù)生產(chǎn)的固化爐是不實(shí)際的,平時(shí)大家經(jīng)常使用“批次烘爐”,但垂直烘爐的技術(shù)也趨于完善,尤其是高速點(diǎn)膠機(jī)在加熱曲線比回流爐簡單時(shí),垂直烘爐完全能夠勝任。垂直烘爐使用一個(gè)垂直升降的傳送系統(tǒng)作為“緩沖與累加器”,每一塊PCB都須通過這一道工序循環(huán)。這樣的結(jié)果就是能保證足夠長的固化時(shí)間,而同時(shí)減少了占地面積。
以上是高速點(diǎn)膠機(jī)廠家總結(jié)的點(diǎn)膠固化工藝解析,如果大家有更好的想法或意見,歡迎提出一起探討!




 全國服務(wù)熱線
全國服務(wù)熱線